
�O���l���������賿�O�������l��������� ��M1 Ultra��оƬ��
оƬ��ُ�W��ע�����χ������ڙ�IC�����̬F؛�YԴ��оƬ��挍�r��ԃ���ИI�r���������ُ����ICоƬ�����Ȍ��IоƬ��ُƽ�_��
�O���ڕ��h������ M1 Ultra оƬ�����S������ą�������1140�|�w���w�ܣ�20��CPU��16 �����܃Ⱥ˺� 4 ��Ч�Ⱥ�)�����64��GPU��32���W�j���棻2.5TB/s������ݔ����8000GB/s�ȴ控�����128GB�yһ�ȴ档

M1 Ultra �� Apple оƬ����һ���Α�Ҏ�t׃���ߌ��ٴ����@ PC �ИI��ͨ�^�ɂ�M1 Max оƬ���҂��� UltraFusion �҂������B�ӷ��b�Y�� Apple оƬ�Uչ��ǰ��δ�е��¸߶ȡ�
�O����Ӳ�����gEspressif������������Johny Srouji��ʾ:�{����������CPU������� GPU�������������y�����ţ�ProRes Ӳ�����ٺʹ����yһ�ȴ棬M1 Ultra ������M�ɞ�������������Ă���Ӌ��CоƬ��
�O����Ultra Fushion�ܘ�������֪��Ҫ����������оƬ������Ҫ�ѷe������·�;��w�ܡ���ˇԽ���M��ͬһ�^��ľ��w��Խ�࣬оƬ��������Խ�ߣ��@Ҳ���˂�������M��ˇ��ԭ��֮һ��
Ȼ������Ŀǰ�Ĺ�ˇ�ͼ��g�l���£�������w���^�࣬���ʌ����ͣ����ʌ����ͣ�ÿ��оƬ��׃�÷dz����F����ô������ڽ��ͳɱ���ǰ�������쳬Խ�O��оƬ�أ�
�����O��������M1 Maxͨ�^�[�������g��оƬ���Bģ�KUltraFushion�ܘ����ɉKоƬ��ƴ�Dһ�Ӻ϶���һ��
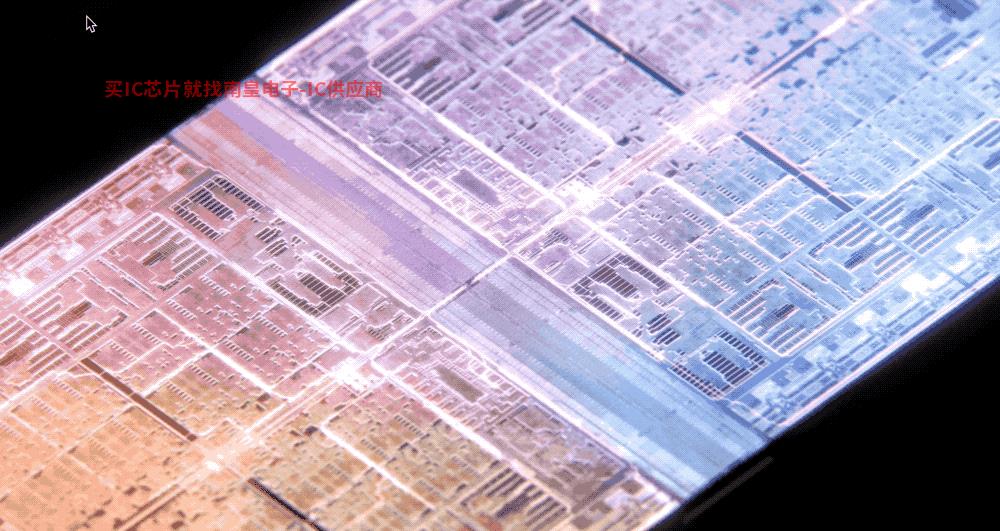
�O���ġ�UltraFushion���䌍����Die to Die Connection����оƬ�OӋ�У�ͬһ���b��package��ʹ�ö�����Ƭ��silicon���������OӋ�˘O����ٵĻ�ͨ����ʹ�@�ɂ���Ƭ�܉���ͬһ��оƬһ�ӹ�����
UltraFusionʹ����1�f�lDTD���_2���B��.5TB/s���Ļ��ٶȘO�ߣ��ܺĘO�ͣ�������ǎKdie�ϰ��b�����ʵ��������h���ڳ�����оƬ�����DTDҲ���J����δ��оƬ���ܰlչ������ĵ�·��

ֵ��һ����ǣ�M1 Max��СоƬ����A(Chiplet)���OӋ�У�оƬģ�K�ѯB����оƬ(MCM)����2-tileʹ���Ҏ��CPU��GPU��NPU�ăȴ控�����ȴ�����������2xM1 Max��Ҏ��
�c�A���оƬ�B�ӌ�������һ����Ȼ���O������Ψһһ�l·��AMD ���� 2017 ���������MCM ������ 2019 ��������Chiplet �OӋ��δ���İlչڅ�����Mһ����߶ѯB���������F���^�� 3D �ѯB��Ҳ�����f�����H�H�� 2D ���ϔUչ��ҲҪ��ֱ����Uչ��

�A�麣˼�ڇ�����IҲ��ͬ�ӵ��뷨��2021��5�£��A�鹫�_���pо�B�ӌ���������ʾ14nm���g���_7nm�@����Ϣһ����������ȫ���������˟��h��������ȫ������Pע�������v14nm�c7nm����֮�g����Ҫ�^�e��оƬ��e��ͬ��7nm���w�ܔ����������ӣ�������Ȼ����ߡ�
�����ܮaƷChiplet�@�l·�ߵ�֪ͨ���Ñ�@���Ͻ�ʺ��DZ�ʾ�@�wM1Ultra�@���O��Ұ�ĵ��Mһ�����m����������е��O��Ҳ�D����Chiplet��ˣ��@���������ܮaƷ���ܕ���δ�������M�I������Chiplet�@�l·�����ߵ�ͨ��Ŀǰ��оƬ�M�ϯB���я���Փ�D׃��F������оƬ���b�ĽǶȁ�������2�_ʼ.5D���b����3D���b��о��(Chiplet) �ṩ������ܺ�����`���ԡ��_�e늣�Ӣ�ؠ������ǣ�AMDʮ�ҹ�˾�ѽ���ȡ�Єӣ���ͬ����UCIe�ˡ�(Ԕ��:Ӣ�ؠ���AMD��Arm�ȾŴ���I����UCle�_�Ř˜ʣ����MChiplet�lչ��
UCIe�˵ij����nj�СоƬ������_�Ż��Įa�I�lչ���B����ͬ�Ŀ͑�ͨ�^���NСоƬ�aƷ�M����������
δ������Chiplet����ģʽ��оƬ����һ����������ϵ�y�����Ԏ���������`���Ժ��µęC����
оԭ�ɷ�����˾��ʼ�ˡ������L�濂�ô���������ʾ�������ИI���ԣ�Chiplet�ژ˜ʺ����B�����ϣ�Chiplet�������µĿɻ������M�������f�h��ܛ�����Bϵ�y����оƬ����Ͱ��b�����˶�оƬģ�K (Multi-Chip Module��MCM) �I�գ�Chiplet���������h����ASIC������߾��A�S�ͷ��b�S�����a�������ʣ��댧�wIP������Chiplet�����̣���������IP�����оƬ�OӋ�������˴�ҎģоƬ�OӋ���T����
�������h������I�^�m���MChiplet���a��2.5D/3D�_�l��y���g��
- Micro LED����AR2026�꣬�������R��Ӌ�_��4100�f��Ԫ
- �Q�O������� iPhone 15 Pro ���������� 8P �R�^���� iPhone 15 Ultra �����R�^����ʹ��
- �CƸ������Ԫ�����°lλ�������L��2021��ͬ�����L37%
- �wӢ˼�����ܲɼ�����ͨ���ܲɼ���ʲô�^�e��
- 2030��ǰ����������Ͷ�Y640�|��Ԫ�M���аl��
- ��ͨ�Uչ���ܔz���^��Q�����aƷ�M�ϣ�����I�����к��S�������ṩ��ȫ֧��
- iBPMS�ʹ��a�Ԅӻ����Ă����m����I��
- ��̩��Ͷ�Y �_PCB�S�����M
- AMD Zen4�J��7000ȫ���ع�:16����5.7GHzһ�w�_�죡
- ��ͨ:�c�_�e늡����ǃɴA�S�������M��ˇ��������
- VIAVI����棺2021������635������5G�ij��У�5G���wȫ��1947������
- BOE�����|����2022��һ����:�I�ճ�500�|Ԫ ���|���lչ�������M